一、苯并噁嗪树脂的发展史
普通酚醛树脂具有原料来源广泛、价格低廉、生产工艺成熟等优点,所以迄今它在合成树脂中仍占有重要地位。但由于普通酚醛树脂使用温度低于120℃,在其固化过程中发生缩合反应时放出小分子,所以难以制得厚壁制件和耐高温的层压材料。
本节介绍一种特殊的酚醛树脂——苯并噁嗪树脂。苯并噁嗪化合物即3,4-二氢-1,3-苯并噁嗪(以下简称苯并噁嗪),一般都采用伯胺类化合物、酚类化合物和甲醛经缩合而制得,该类化合物在高温或催化剂如路易氏酸、咪唑等的作用下发生开环聚合,形成结构类似于酚醛树脂的含氮固化产物,其典型的结构式如下。

苯并噁嗪作为一类新型的热固性树脂,有许多优异的性能。比如其固化时没有小分子放出,具有较高的玻璃化转化温度,较小的吸湿性,较好的分子设计性,以及固化时接近零的收缩率等。它克服了传统酚醛树脂的许多缺点,同时保留了它的一些优点,比如较好的热性能,阻燃性能和电性能等。另外原料来源广,价格低廉。
早在1944年,Holly和Cope在合成曼里期反应产物中意外地发现了苯并噁嗪化合物。
Burke等人于1949年对苯并噁嗪化合物的合成进行了系统研究和表征。由于苯并噁嗪化合物未能及时得到开发应用,其合成研究也一度进展缓慢。
直到1973年,Schreiber首次报道了经苯并噁嗪开环聚合制备酚醛塑料的研究工作,此后,苯并噁嗪化合物的合成研究迅速开展起来.
特别是1990年以来,美国Case Western Reserve大学H.Ishida等以双酚A为原料,合成出双官能团苯并噁嗪化合物,并对其固化机理、物理和力学性能、耐湿热性能、体积效应和热分解性质等进行了相当详尽的研究,将苯并噁嗪的研究和应用推向了一个新的阶段。 此外,国内四川大学顾宜教授课题组开始进行苯并噁嗪的合成、性能表征、加工和应用方面的研究,并有数种产品进入工业化生产,得到实际应用。
此后,日本、韩国、台湾,国内一些科研院校和研究所也纷纷对苯并噁嗪的合成,固化反应及其应用进行研究。
二、苯并噁嗪的合成
㈠ 苯并噁嗪一般有两种合成路线:
伯胺化合物与甲醛反应形成 N, N-二羟甲基化合物,通过控制 PH 值,使该 N, N-二羟甲基化合物稳定,以避免脱水醚化或分子内脱水生成西夫碱;接着,加入酚类化合物,N, N-二羟甲基化合物先在酚羟基的邻位反应,随后再与酚羟基之间脱水闭环,产生苯并噁嗪。其典型的反应式如下。

酚类化合物也可与甲醛、胺类化合物按摩尔比 1∶1∶1 反应,生成曼里期碱,在碱性条件下,曼里期碱再与甲醛进一步缩合、环化,也生成苯并噁嗪。其典型的反应式如下。
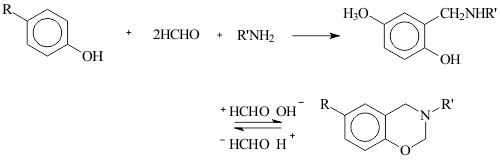
㈡ 苯并噁嗪合成方法也很多,见表5-7-1。
表 5-7-1 苯并噁嗪合成方法比较
合成方法 |
特点 |
溶液法 |
反应易控制、产率高,生产能力和利用率低,成本高 |
悬浮法 |
反应平稳、收率高 、环境污染小 |
本体法 |
效率高、污染小,反应较难控制 |
㈢ 苯并噁嗪分子可设计性:
1.单环苯并噁嗪,由 一元酚、一元胺、甲醛合成的单环苯并噁嗪。

2.双环苯并噁嗪,以二元酚、一元胺、多聚甲醛(或以二元胺、一元酚、甲醛)为原料,合成的双环苯并噁嗪中间体。
2.1 二酚型苯并噁嗪

2.2 二胺型苯并噁嗪(与普通双酚型相比,其交联密度要高,耐热性要好)

3.多环苯并噁嗪

三、苯并噁嗪树脂的固化反应
苯并噁嗪树脂的固化反应可以分为热引发固化和催化固化两种。苯并噁嗪的固化是通过分子中噁嗪环开环进行的。含氮和氧的噁嗪环是六元环结构,这种结构以扭曲的半椅式结构存在。该结构较为稳定,因此噁嗪环的开环温度通常很高,苯并噁嗪的热固化反应要在200℃以上才能进行。
Burke等人最早报道了有关苯并噁嗪与酚类化合物进行活泼氢开环反应的机理:

shida等人从上世纪九十年代以来开始研究苯并噁嗪树脂的催化固化反应动力学。他们使用动态DSC的方法计算了纯化的苯并噁嗪单体和含有少量二聚体或齐聚物分子的苯并噁嗪树脂的活化能以及反应级数,并由此研究了二聚体或齐聚物中酚羟基的邻位上活泼氢对苯并噁嗪固化反应的催化作用。结果表明,两种苯并噁嗪树脂在固化反应进入扩散控制阶段以前均为自催化反应,活化能在100kJ/mol以上,反应级数约为2。酚羟基的存在起到催化的作用,它降低了固化反应的诱导时间并提高了反应速率。
他们还研究了羧酸催化苯并噁嗪固化的反应机理,研究结果表明作为催化剂的有机酸类电离常数的大小(即酸性的大小)决定了噁嗪环开环反应中间体的结构,从而影响开环反应的过程及其产物。
此外,Ishida等人还利用某些阳离子引发剂研究了苯并噁嗪树脂催化开环固化的阳离子反应机理。催化剂中的阳离子首先进攻噁嗪环中负电荷密度较大的氧原子,于是噁嗪环中C-O键上的电子云离域程度加大,正电性的C原子与别的噁嗪环上的O原子连接,形成新的负氧原子,反应得以不断的进行下去。结果表明阳离子催化苯并噁嗪的产物结构不同与热固化的产物结构,如图所示。

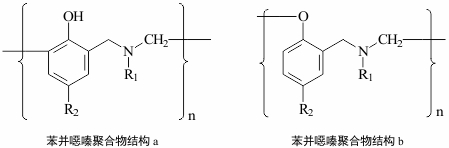
除了以上Ishida等人对苯并噁嗪催化固化反应的研究以外,国内的顾宜教授及其课题组也在相关领域做了深入细致的研究工作。刘欣研究了胺类催化剂体系和环氧树脂/胺类体系催化苯并噁嗪树脂的开环聚合反应的机理。研究结果表明,对于叔胺类催化剂,如苄胺、咪唑等能够催化苯并噁嗪开环聚合,条件是体系中必须有活泼氢存在,苯并噁嗪化合物中酚核取代基的类型,数量以及酚核取代位置,对开环聚合反应的进行及产物结构有很大影响。
其中,咪唑的催化反应机理如下:

咪唑/环氧/催化机理:
咪唑既可催化苯并噁嗪开环,又可催化环氧树脂基开环,反应较为复杂,即可均聚,又可能共聚,就共聚反应而言,反应可按两种路径进行:
路线一,咪唑先催化苯并噁嗪开环,生成的酚羟基与环氧基反应

路线二,咪唑先催化环氧树脂基开环,生成的烷氧基负离子再催化苯并噁嗪的噁嗪环开环。

四、苯并噁嗪树脂的应用
㈠ 无卤阻燃
苯并噁嗪本身属于含氮杂环化合物,氮含量不低于6%(wt),所以说在无卤化过程中,首当其冲,大有用武之地。最简单、最大量应用的是和含磷材料复配,达到磷氮协同阻燃,这类技术和产品在日本已经大面积推广中。
日本专利JP2002249639 则报道了在苯胺-线形酚醛树脂型苯并噁嗪和三聚氰胺改性线形酚醛树脂中添加磷酸酯来提高苯并噁嗪的综合性能。通过该方法制备的覆铜板具有优异的钻孔性和耐锡焊性,其阻燃性能达到UL-94V0级要求。
另外,近来不少研究一些多苯环结构(或萘环结构)的苯并噁嗪,本身基本上就能达到阻燃UL-94 V-0级,而且性能也大幅度提升。
㈡ 低吸水率
Ishida等研究报道,苯并噁嗪的低吸水率与其固化后存在大量的分子内和分子间氢键有关,其简单示意图如下:

Garrett等研制了一种具商业用途的低吸水率的新型封装材料,用于封装10mm2的27mmX27mm焊球阵列的芯片,能通过新的回流焊条件(85%RH/85℃,240℃),玻璃化转变温度高达180℃时,其吸水率比一般环氧灌封料大约降低了30—50%,综合性能超越了现有的所有环氧灌封料。
日本专利提出多种具有高Tg和低吸湿性的环氧树脂/苯并噁嗪共聚物组成的可用于封装材料的高性能环氧组成物
㈢ 低体积收缩率
电子元器件表面常常需要涂覆环氧树脂作为保护。这种涂覆材料要求低温快速固化,固化后体积改变小,成膜均匀平整。
Ishida等人研究发现苯并噁嗪聚合物具有一个独特的优点,其聚合接近零收缩或有轻微的膨胀。因此,通过在环氧灌封料中引入苯并噁嗪树脂与环氧共聚,以降低脱模、后固化和冷却时树脂固化物的体积变化。
美国专利US6376080中提出一种用于涂层和模塑的封装材料,以杂环二碳基酸作为苯并噁嗪树脂固化的催化剂,将材料加热至150-250 ℃ /1-5min固化或 160-210 ℃ /2-4min固化。固化后产物玻璃化转变温度为140-220℃,介电常数为3.2-4.0,具有高阻燃性,脱模、后固化和冷却时体积变化小于0.15%,最小时可小于0.10%。
㈣ 低线性膨胀系数
一般使用的环氧树脂的线性膨胀系数最低为 65 ppm/℃,而固化后的苯并噁嗪树脂的线性膨胀系数大约在 50 ppm/℃与60 ppm/℃之间。因此,采用苯并噁嗪树脂作为基体树脂,添加较少的填料就可以达到较低的线膨胀系数,同时保持了较低熔融粘度,有利于制备高性能高可靠性的封装材料。
㈤ 灌封材料的加工性优
在先进的圆片级封装过程中,常规环氧树脂灌封料在加工条件下易在半导体圆片表面出现凝胶和部分固化的情况,使封装表面不平整,从而可能导致粘结和电气连接等很多问题,对芯片性能造成影响。新型的苯并噁嗪基灌封材料则特别适合这种封装方式的需要。苯并噁嗪灌封材料在加工过程中加热至50-100℃时,可以保持流动态,半导体圆片可以在室温下放置一段时间,不需冷却,不会凝胶和固化,因此可在半导体表面形成均一的覆盖层。
㈥ 电子封装材料与高导热材料
Ishida等人通过在单环苯并噁嗪苯环上引入活性官能团,如乙炔基、烯丙基、马来酚亚胺基等制备出一系列其固化产物具有高的热稳定性,高机械性能的低粘度的苯并噁嗪树脂。并将这种树脂与环氧树脂、乙烯基单体或者其他苯并噁嗪共聚。此外,通过加入不能与其共聚的组分聚合,可形成交联互穿网络结构。这类热固性苯并噁嗪共聚物具有优良的刚度、加工性和优异的热性能,作为电子封装材料有良好的应用前景。
目前常规的微电子封装材料的热导率一般在0.7W/mK左右。采用热导率比较高的硼氮填充环氧,其热导率达到4.5W/mK。 Ishida等人以片状硼氮化合物填充苯并噁嗪,制得一种热导率达5-37.5W/mK的高导热的复合材料。这种复合材料组分中必须包含一种或多种苯并噁嗪树脂和硼氮化合物微粒。其中氮化硼微粒填充量需达到60%以上,以能够在材料中建立起硼氮化合物热传导通道,热传导通道的建立极大地提高了材料的热传导能力。同时硼氮化合物取代常规的硅填料赋予材料低热膨胀系数和高电阻。在苯并噁嗪树脂中填充68%体积比的硼氮化合物,热导率高于20W/mK;硼氮化合物体积填充达72%时,热导率在25W/mK以上。
㈦ 耐烧蚀材料
传统热固性树脂高温裂解后的残炭率多低于50%,而Ishida等人经分子设计所得的聚苯并噁嗪的残炭率较高,尤其是含特殊反应性基团(如炔基、氰基等)的苯并噁嗪,其成碳性能很好,在氮气氛中800℃时的残炭率可达60%以上,最高可达80%以上,因此,这类苯并噁嗪可用作耐烧蚀材料。
Dow公司则将苯并噁嗪与呋喃化合物混合,得到高残炭率的复合材料,也可用作耐烧蚀材料。
|

